EM-Suiteシミュレーション例
-
Phase-Shifted Lineでのガラス欠陥
コンタクトホールでのPhase Shift Mask
クロムのアライメントエラーを伴ったPhase Shift Mask
Phase Well トポグラフィ
OPCでの機能
Phase-Shifted Phase-Shifted Lineでのガラス欠陥
0.18um のphase-shifted line (printed at lambda=0.248um) にガラス欠陥があります。この欠陥がどのようにaerialイメージでのライン幅に影響するのか。この欠陥は致命的かをシミュレーションします。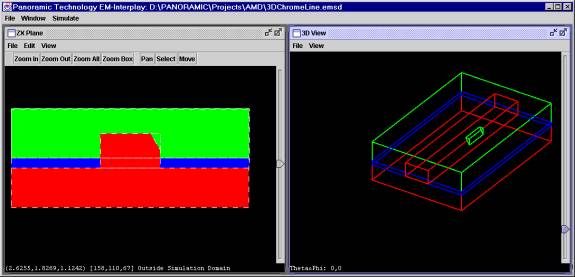
2D 断面(左)で欠陥がphase-shifterの右上の角にあります。 The 3D view (右) で欠陥の長さがライン幅と比較して示されています。.

シミュレーションの結果ではこのガラス欠陥はaerial imageでライン幅にかなりの影響を及ぼしていることがわかります。
コンタクトホールでのPhase Shift Mask
周期的なアレーで 0.18um コンタクトホールは lambda=0.248um.でプリントされるとします。 もう一つのコンタクトホールは180度フェーズシフトしています。The phase shifting wellsは vertical sidewallsで corner radiiはありません。The phase-shifted コンタクトホールは unbiasedでnon-phase-shifted コンタクトホールと比べて通過する光はより少なくなるはずです。よって、the phase-shiftedコンタクトホールはthe aerial imageではより小さくなるはずです。.


左側の図はxy−クロム面上の断面図です。青がクロムで赤はクロム面で空いているAirを表しています。右側の図は二つのコンタクトホールの断面図zx−面を示します。右側のコンタクトホールは180度のphase wellがあるのに注意してください。

トポグラフィの 3D viewで何がシミュレーションされるかよく理解できます。ドメーンの上半分はガラス(緑)で覆われています。下の半分はAir(赤)で満たされています。ガラスの下に4つのコンタクトホールが空いている薄いクロム(青)の層が積まれています。4つの内2つのコンタクトホールには180度のphase wellsがあります。
以下がシミュレーション結果です。
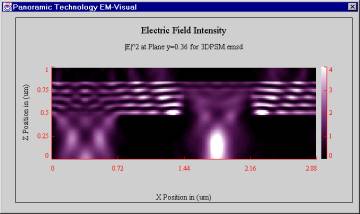
zxカット面でのThe near fields (electric fields intensity at the mask) .
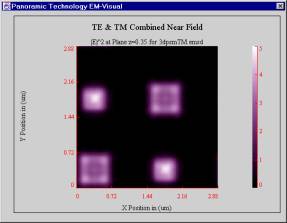
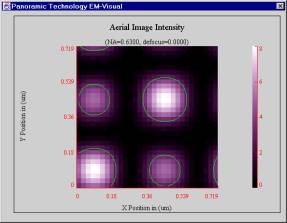
左図は near field intensity just after transmission through the mask (クロムのすぐ後ろ) 右図は the aerial image calculated (with EM-Aerial) by propagating the near field intensity through the projection optic to the wafer. Partial coherence effectは考慮されています。
クロムのアライメントエラーを伴ったPhase Shift Mask
減衰されたフェーズシフトマスクでのライン/スペースパターン (2D TEMPEST シミュレーション)を得るにはフェーズ端に関してクロムの様様な相対位置に関してシミュレーションをおこないます。

EM-Interplayでトポグラフィを設定します。 三つの異なったトポグラフィを作ります:アラインされたもの、ミスアラインされたもの、そして、アンダーカットされたもの。 アラインされたトポグラフィはガラスのフェーズ端がクロムラインの左の端と一致しています。ミスアラインされたトポグラフィはガラスのフェーズ端がクロムラインの左の方向にあります。一方、アンダーカットされたトポグラフィ(上図のZX面の窓に示されている)はクロムラインの上にガラスのフェーズ端があります。次の図は三つのトポグラフィの比較をよりよく表しています。

Calculating aerial images for the three topographies with EM-Aerial.
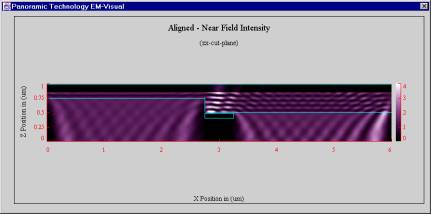
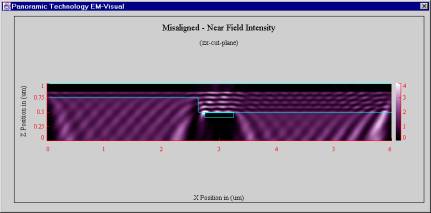

三つのトポグラフィのThe near fields。 分かりやすくするため、ガラスとクロムの輪郭はthe intensity fields.で重ねています。クロムラインの位置と比較してガラスフェーズ端の様様な位置に注意してください。
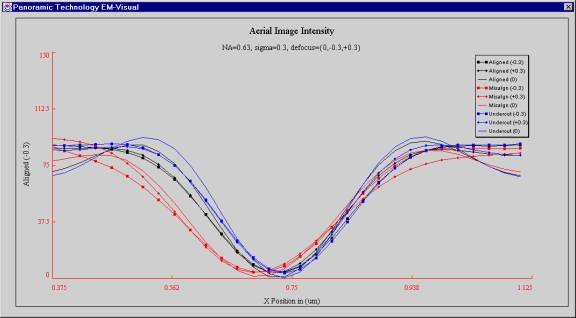
三つのトポグラフィはフォーカス(ウエハ上で+/-0.3um )を通してほとんど同じです。ミスアラインされたトポグラフィ(赤)は −x方向により広いラインシフトがなされています。アンダーカットされたトポグラフィは+x方向に少しシフトされて、プリントされます。
Phase Well トポグラフィ
二つのフェーズシフトされたコンタクトホールの内、一個にInterior corner rounding が施されている場合。

マスクのトポグラフィの設定は簡単です。箱型と円錐の組み合わせで二つのフェーズウエルの一個の内側の角の丸みを作っています。 YZ-view でウェルを通した断面が見られます. "Show True Outlines"機能でどのFDTDグリッドセルがどんな材料かユーザは正確に見ることができます。 3D Viewでどのコンタクトホールが丸みを持っているか解ります。(緑:ガラス、赤:空気、青:クロム)
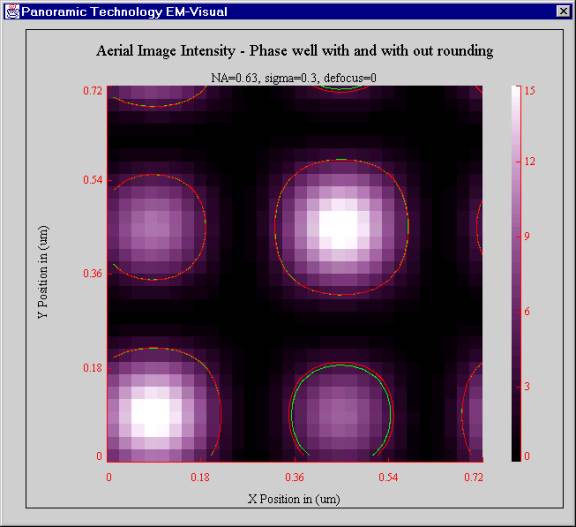
シミュレーションの結果です。一定の強度の輪郭で丸まったウェル(緑)と丸めてないウェル(赤)が示されています。予想通り、より少ない光が丸まったウェルを通過しています。
幅0.25um 、 長さ0.75um (ウエハー上での寸法)のラインのAerial イメージ (lambda=248nm)で次の三つの条件で,OPC機能を計算します。
1) 理想的なマスク (透過は0か1の値となる)
2) TE入力の実際のマスク (TEMPESTでシミュレーション)
3) TM入力での実際のマスク (TEMPESTでシミュレーション)
3D TEMPESTのシミュレーション用にマスク上のトポグラフィを記述します。XY-cut-planeでのトポグラフィはファイルとして出力され、理想的なマスクのtransmission の機能を発生させるのに使います。EM-Aerialで三つのケースのaerialイメージを計算します。EM-Visualで全てのフィールドを視覚化します。


上の図は長さ0.75um、 幅0.25um(ウエハー寸法)でOPC機能を伴ったラインの部分です。3Dのトポグラフィが左側に示されています。2Dトポグラフィ(3Dトポグラフィでのxy-cut-plane)はファイルとして出力されます。これから、理想的なマスクの場合のmask transmission functionが生成されます。
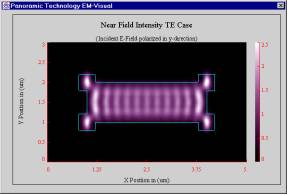
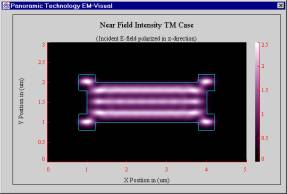
The near fields で明らかにポーラリゼーションの効果がわかります。TEの場合 (左), the incident electric fieldは y-方向にポーラライズされていることが解ります。一方、 TMの場合 (右), the incident fieldは x-方向にポーラライズされています。トポグラフィがよ良く分かるように上書き(緑色の線)されていることに注意してください。The aerial imageはこのプロットのくみ合わせたもののAerialにフィルターされたものとなります。
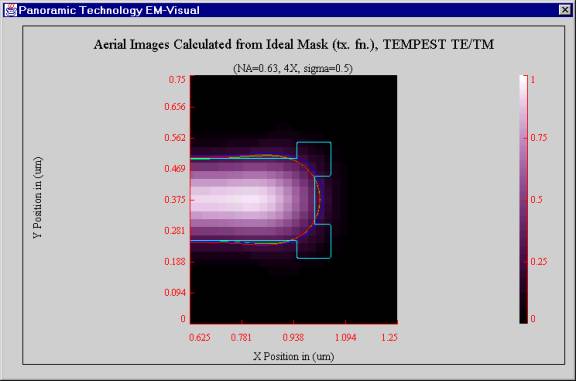
理想的なマスク (transmission function, scalar theory)とTEMPESTでシミュレートされた TE と TMの場合を 比較しています。全て、clear fieldsに対して正規化しています。輪郭は30%のところです。 予想されたように、回析TEMPESTでシミュレートされたaerial images(緑がTE、赤がTM)は理想的なマスク(青)と比較して、若干のline-end-shorteningが出ています。
株式会社インターソフト
〒190-0003 東京都立川市栄町6-26-17
tel.042-538-2682
fax.042-538-2681
お問合せ:sales@intsoft.co.jp
http://www.intsoft.co.jp